Die Attach(芯片贴装)
芯片贴装(Die Attach)是封装工艺中非常关键的一步,其主要目的是将单颗芯片从已经切割好的wafer上抓取下来,并安置在基板对应的die flag上,利用银胶(epoxy)把芯片和基板粘接起来。
其主要过程如下图所示,可以细分为三步:1.点胶(Dispense);2.取芯片(Pick up);3.贴片(Placement)。
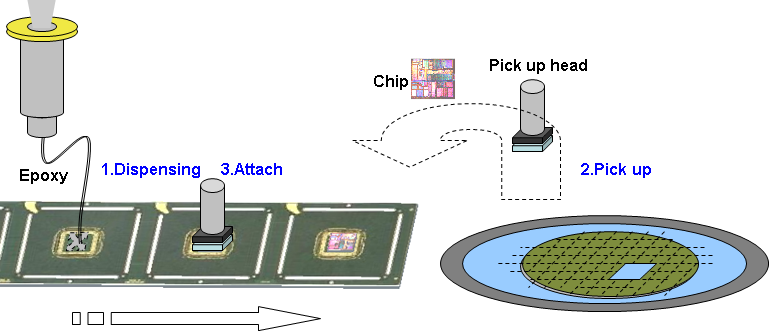
芯片贴装过程示意图
1. 点胶:
银胶的主要成份是环氧树脂、银粉(Silver)和少量添加剂。环氧树脂和添加剂主要起粘结作用,而银粉主要起导电导热作用。成品银胶被装在针筒注射器中,零下40oC的低温保存,防止变性。使用前,将银胶取出回温,并在离心搅拌机中搅拌均匀,挤出其中的气泡。
点胶有三种模式:戳印(Stamping)、网印(Printing)、点胶(Dispensing)
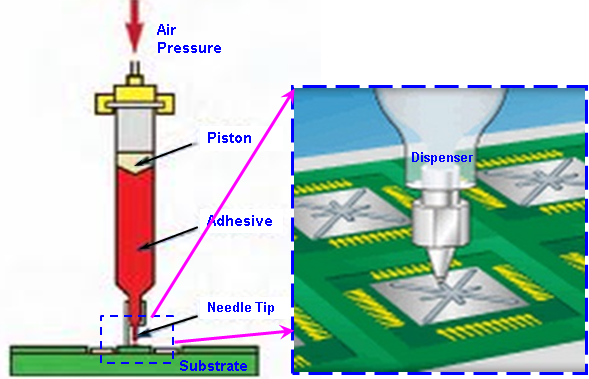
点胶(Dispensing)示意图
2. 取芯片:
切割后的Wafer被安装在固晶机的Air Bearing Table上,取芯片时,Ejector Pin从wafer下方将芯片顶起,使之便于脱离tape,同时Pick up head从上方吸起芯片,如下图所示。
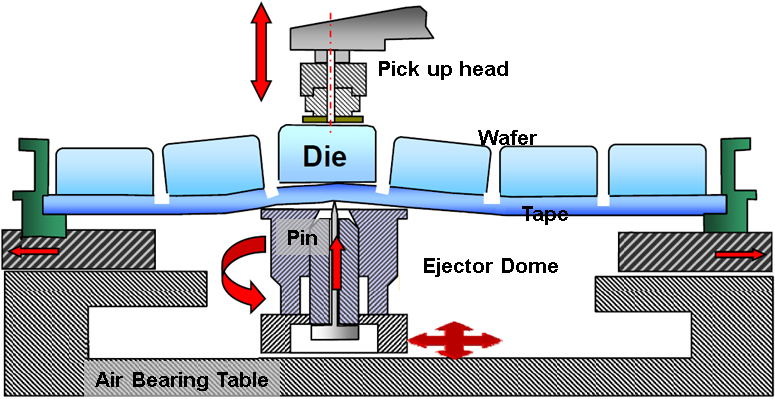
芯片抓取示意图
3. 贴片:
基板被传输到固晶机的贴片平台(Die bond table)上,平台被加热到120oC(防止基板吸收湿气,使芯片贴装后预固化)。点胶之后,已抓取芯片的Pick up head运动到基板上方,以一定的压力将芯片压贴在点胶的die flag上,如下图所示。完成贴片的基板被传输到基板盒(Magazine)中,流入下一工序;
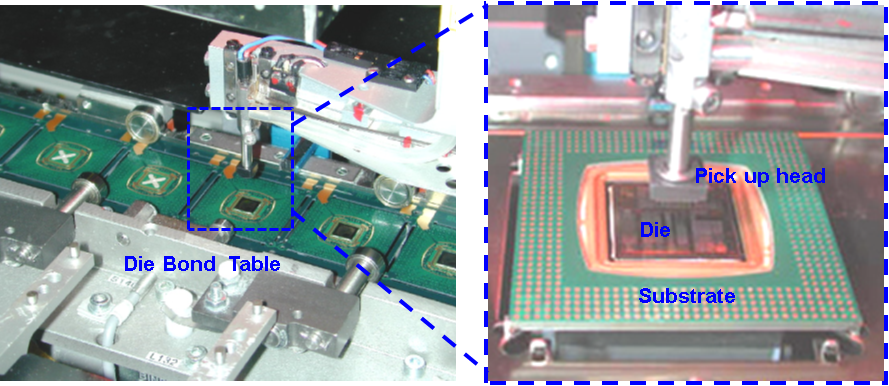
芯片贴装图
常用的Die Attach设备有ESEC、ASM、Datacon等,以下视频来自Samtec和ESEC,仅供参考。
Epoxy Cure(银胶烘烤)
贴片后的基板装回基板盒,放进热风循环烤箱,如下所示,175oC烘烤60~120分钟,使胶水中的溶剂挥发,胶水完全固化,芯片牢贴在基板上。烤箱内充满氮气,防止氧化。
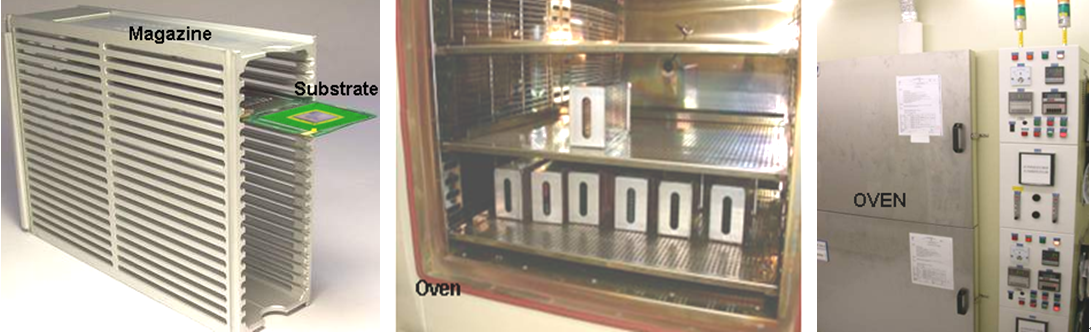
银胶烘烤
下一章节,我们会继续SiP的工艺流程,讲述Wire Bonding(邦定),敬请关注。








