Wafer Back Grinding(晶圆研磨)
为保持一定的可操持性,Foundry出来的圆厚度一般在700um左右。封测厂必须将其研磨减薄,才适用于切割、组装,一般需要研磨到200um左右,一些叠die结构的memory封装则需研磨到50um以下。常用的Wafer研磨、切割流程如下图。
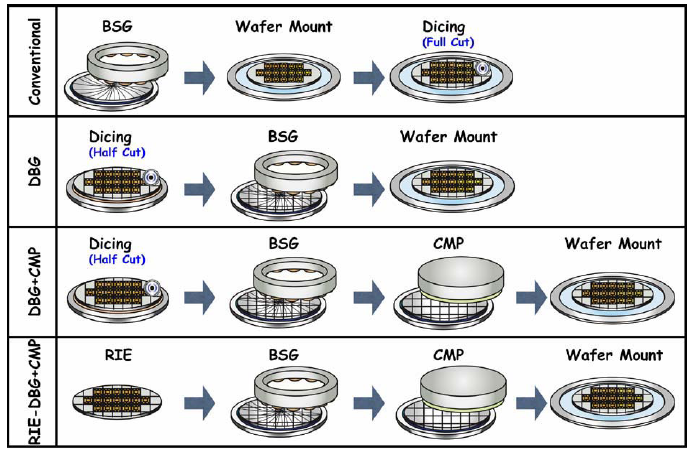
常用的几种BG流程
晶圆研磨主要可分为下面三个步骤:Taping(贴膜) → Back Grinding(背面研磨) → Detaping(去膜)
Taping(贴膜)
在晶圆的正面(Active Area)贴上一层保护膜,保护芯片电路区域在研磨时不被刮伤,如下图所示。
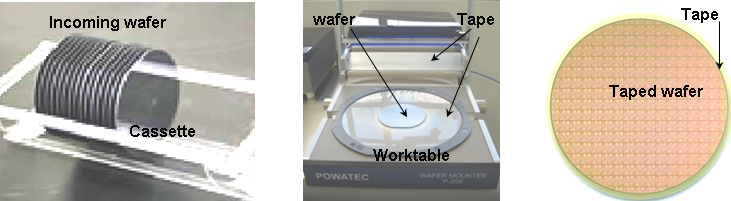
进料wafer、贴膜机及贴膜后的wafer
Back Grinding(背面研磨)
将贴膜后的晶圆放在真空吸盘上,真空吸盘其旋转。研磨砂轮转动的同时对晶圆施压,将其研磨到最终需要的厚度,如下图所示。
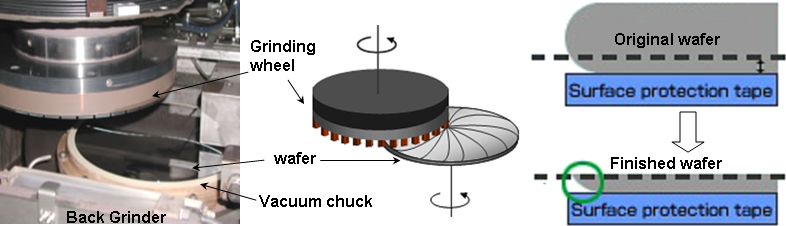
BG示意图
Detaping(去膜)
晶圆研磨后,将保护膜经紫外光照射后剥离,如下图。

研磨后的Wafer
Dicing(晶圆切割)
晶圆切割流程:Wafer Mounting (晶圆贴片)→ Die Singulation(芯片切单)
Wafer Mounting(晶圆贴片)
贴膜的主要作用是防止芯片在切割时散落,另外也方便后续Die Attche工序拾取芯片。
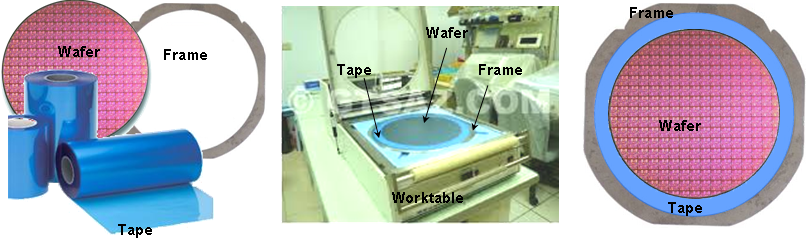
Wafer贴片材料、设备及贴片效果图
Dicing芯片切割)
芯片切割又叫划片,目前主要有两种方式:刀片切割和激光切割。
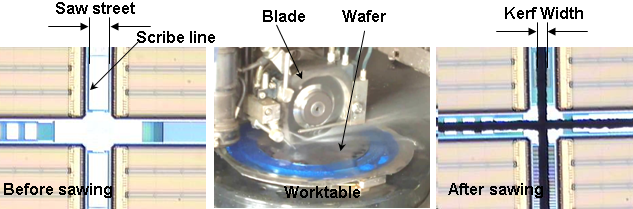
Wafer切割,及切割前后wafer细节对比
Wafer切割后,所有的芯片已完全分离开,将其放入晶圆框架盒中,流去下一工序。

晶圆及提篮
下一章节,我们会继续SiP的工艺流程,讲述SMT贴片,敬请关注。








