芯片与封装的互联方式常见的主要有WB和FC两种,上节介绍完了WB工艺,本节主要讲FC工艺。
芯片倒装(Flip Chip),顾名思义,需要将芯片正面(有源面)朝下倒置,实现与载板组装和互联键合。使用倒装焊工艺,首先要将芯片处理成FlipChip的形式,需要在芯片表面布置上连接点,用来实现芯片I/O电路和封装载板的连接,此连接点称为晶圆凸点(bump)。凸点制作工艺很多,如蒸发/溅射法、焊膏印刷-回流法、电镀法、钉头法、置球凸点法等,各种凸点制作工艺其各有特点,关键是要保证凸点的一致性。凸点按材质可分为锡铅凸点(Solder bump)、铜凸点(Copper bump)、金凸点(Gold bump)等,详见下图。凸点长度很短,具有很小的感性系数,有益于芯片电性能的发挥;另外凸点采用面阵列布置,极大的提高信号互联密度,满足不断增长的I/O数需求,目前大规模集成电路芯片普遍采用FC形式,如CPU、GPU等。
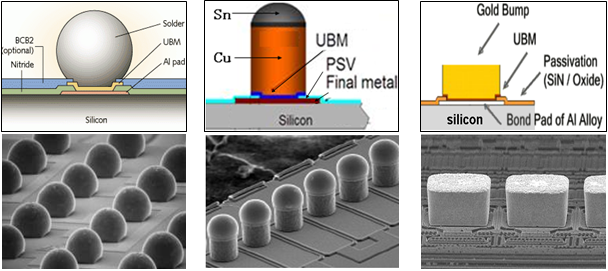
常见的三种凸点形式及结构
FC倒装技术主要有熔焊、热压焊、超声焊、胶粘连接等,现在应用较多的有热压焊和超声焊。
热压焊接工艺要求在把芯片贴放到基板上时,同时加压加热。该方法的优点是工艺简单,工艺温度低,无需使用焊剂,可以实现细间距连接;缺点是热压压力较大,基板必须保证高的平整度,热压头也要有高的平行对准精度,其工艺过程详见下图及视频。
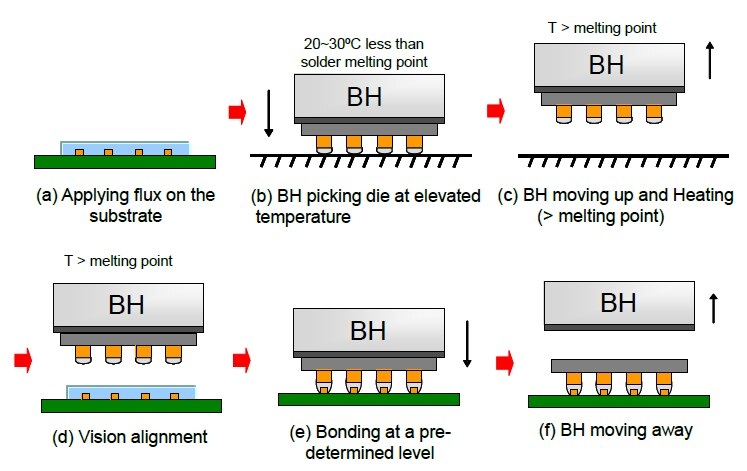
铜凸点芯片倒装过程
超声热压焊接是将超声波应用在热压连接中,使焊接过程更加快速。超声波的引入使连接材料迅速软化,易于实现塑性变形,其优点是可以降低连接温度,缩短加工处理的时间,缺点是由于超声震动过强,可能在硅片上形成小的凹坑。超声热压焊主要适用于金凸点(Gold Bump)与镀金焊盘的键合(详细过程参考下面视频)。
点击视频链接: Thermosonic Bonding.mp4
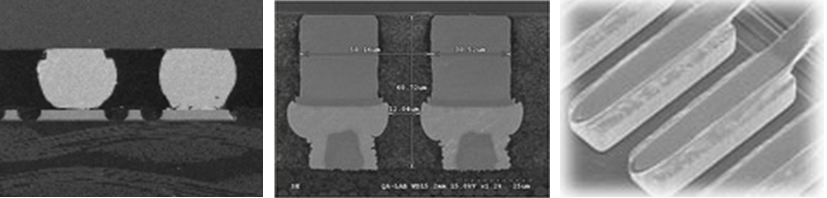
铅锡凸点、铜凸点、金凸点焊接后的焊点
以上章节主要集中讲解封装工艺,没有展开有关封装载板的知识。作为封装工艺中最关键的原材料——封装载板,其加工工艺和尤其表面处理工艺与封装工艺有着密切的联系。如上图中的铜凸点键合工艺,由于凸点上的锡(Cap)比较少,焊接时,载板上的焊盘会将大部分锡吸走,从而不能形成良好的焊点,严重影响封装的成品率和产品的可靠性,而采用用BOL(Bond on Line)工艺,则可以避免这种问题,对应的载板布线和焊点如下图。不同的封装工艺对应不同的基板工艺,两者密切配合,才能完美实现芯片的封装。接下来我们将分章节系列介绍各种封装载板的加工工艺,以期大家对封装有更全面的了解。
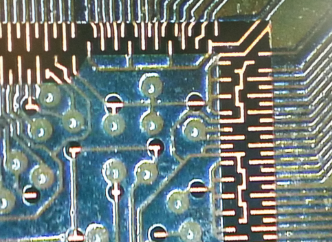
BOL载板








