Plasma Clean (电浆清洗Before WB)
在密闭真空中充入少量Ar、H2、O2中的一种或几种气体,利用RF power在平形板电极形成电场使电子来回震荡,电子激发并电离气体产生电浆,撞击基板和芯片表面,与污染物产生物理或化学反应,利用气体流通将污染物去除。电浆清洗使表面微结构产生官能基或达到一定的粗糙度,增加不同材料之间的结合力,增加焊点的可靠性以及基板与塑封材料之间的结合力,从而提高产品的可靠度、增加使用寿命。

Plasma Clean示意图
电浆清洗主要分以下几种
1. Argon Plasma
纯物理作用、物理撞击可将表面高分子的键结打断,形成微结构粗糙面。
2. Oxygen Plasma
具有化学作用,可以氧化燃烧高分子聚合物,或者形成双键结构的官能子,可表面改性。
3. Hydrogen Plasma
具有还原性作用的气体,可以还原被氧化的金属表面层。
4. Mix Gas Plasma
组合上述气体种类,可达到特殊官能基的形成。
Ar & H2混合气,借由物理撞击对表面的结构产生活化作用,并形成粗糙面增加结合力。Wire Bond工序前,采用此种清洗方式,可以增加焊点的结合力。
O2 & H2混合气,对金属面形成OH-基,Molding 工序前,采用此种清洗,可以增加与Compound间的结合力。
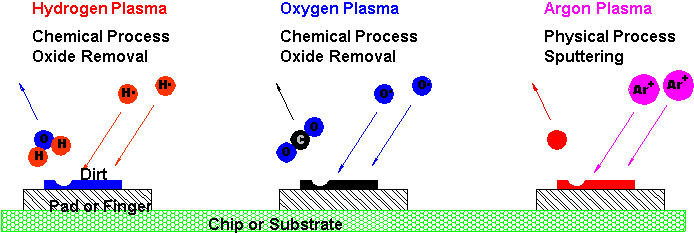
电浆清洗三种原理
Wire Bonding(邦定)
WB是封装工艺中最为关键的一步,主要目的是利用金线(Au)、铝线(Al)或铜线(Cu),把芯片上的Pad和基板上Finger通过焊接的方法连接起来。焊接方式有热压焊、超声键合和热超声焊等,这里主要介绍热超声焊。
热超声焊的主要材料为金线,成分为99.99%的高纯度金,线径一般为0.8mil,1.0mil,1.3mils,1.5mils和2.0mils等。利用超声振动提供的能量,使金丝在金属焊区表面迅速摩擦生热,产生塑性变形,破坏金属层界面的氧化层,两个纯净的金属界面紧密接触,在钢嘴压力作用下,达到原子间紧密键合,形成牢固的焊接。
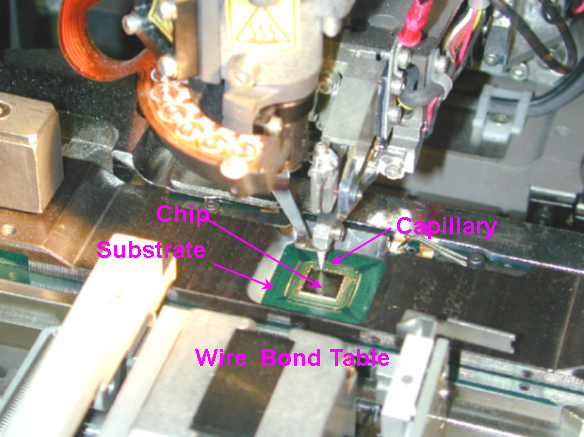
热超声焊
球焊的主要过程如下图:
1) 打火杆在瓷嘴前打火,将金线烧熔成球;
2) 第一焊点:金球在钢嘴施加的一定压力和超声的作用下,与芯片pad连接,形成焊球(Bond Ball);
3) 第一焊点完成后,夹持金线的夹子松开,钢嘴牵引金线上升,并按程序设定的轨迹运动,从而形成一定的线型(Wire Loop)。
4) 第二焊点:钢嘴运动到基板Finger上方,在超声作用下,下压到在基板的Finger上,形成鱼尾(Wedge)形的连接;
5) 第二焊点完成后,钢嘴向上运动,拉出一定长度的金线(为下一步烧球做准备),夹子闭合,金线与Finger的连接被切断。
6) 回到第1),进入下一焊接循环。
WB四要素:压力(Force)、超声功率(USG Power)、时间(Time)、温度(Temperature)。
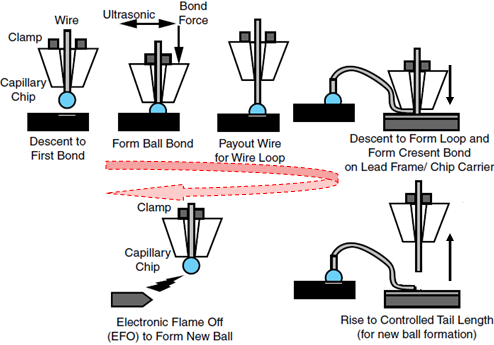
金丝球焊过程示意图
金线焊接完成后的基板效果如下图。
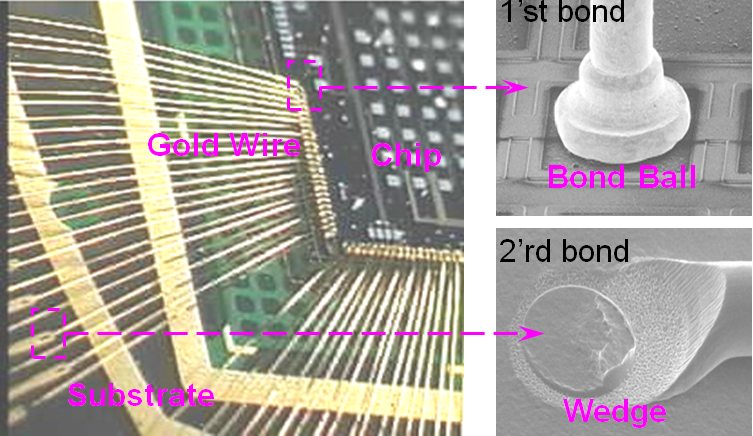
球焊后的基板和芯片,金丝及第一、第二焊点图
下一章节,我们会继续SiP的工艺流程,讲述Molding(注塑),敬请关注。








