芯片封装互联
芯片与封装的互联方式常见的主要有两种,Wire Bonding(引线键合)和Flip Chip(倒装芯片),如下图所示。引线键合工艺,需要分两个步骤,一先把芯片粘结在载板上,实现物理连接,第二步才是引线键合,实现电性连接;而倒装芯片则只需一个步骤即可同时实现物理连接和电性连接。
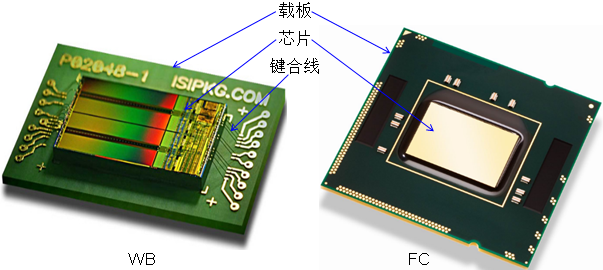
引线键合和倒装封装
引线键合
芯片与载板的引线键合,常用的键合方法有热超声焊、热压焊、超声焊,材料有金线、铜线、铝线等。引线键合根据键合点焊接形式不同,可以分为两种。第一种是球焊(Ball Bonding,一般也称为Ball-Wedge Bonding),常用焊材金线和铜线,其特点是第一焊点是焊球,通过热超声是焊丝与芯片的金属pad融接,第二点为鱼尾(stitch),通过热超声焊将焊丝压接在载板上,详见下图,其具体工艺过程在本系列第6节已做详细介绍,此处不在赘述。第二种是楔焊(Wedge-Wedge Bond),第一焊点和第二焊点都是通过超声压分别与芯片和载板焊接,常用焊材是铝线和金线,详细的焊接过程请参考下面视频。

不同的焊接方式及对应的治具
对于Wedge-Wedge Bond来说,其焊线长度相对较短,电阻电感小,非常有利于高频信号和大电流通过。金线常用在高速高频信号芯片的键合上,如射频微波芯片、光芯片等;铜线、铝线常用在大功率、大电流的芯片焊接上,如IGBT,实物如下图。

Wedge-Wedge Bond实物
金线焊接工艺成熟,但成本较高,在商用领域有被铜线取代的趋势。铜线导电性好,价格便宜,缺点就是硬度太大,键合时需要更大的压力,容易对芯片造成伤害,随着铜线键合工艺的成熟,此缺点正在慢慢被克服。目前金线、铜线的直径一般不超过50um,而铝线直径则从50um到500um不等。
除上述两种常见的键合方式,还有一种带式键合(Ribbon Bonding),其键合过程与Wedge Bonding相似,但材料不是线状,二是带状的,主要有金带和铝带。由于金属带比较宽,可以提供更小的电阻和电感。铝带主要应用在大功率上,金带射频微波器件上,详见下图。其工艺过程,请参考视频。

Ribbon Bond








