IC封装基板简介
IC封装基板或称IC载板,主要是作为IC载体,并提供芯片与PCB之间的讯号互联,散热通道,芯片保护。是封装中的关键部件,占封装工艺成本的35~55%。IC基板工艺的基本材料包括铜箔,树脂基板、干膜(固态光阻剂)、湿膜(液态光阻剂)、及金属材料(铜、镍、金盐)等,工艺与PCB相似,但其布线密度线宽线距、层间对位精度及材料的靠性均比PCB高。
IC封装基板发展可分为三个阶段:
第一阶段, 1989-1999,初期发展。以日本抢先占领了世界IC封装基板绝大多数市场为特点;
第二阶段, 2000-2003,快速发展。台湾、韩国封装基板业开始兴起,与日本形成“三足鼎立”;
第三阶段, 2004年起,此阶段以FC封装基板高速发展为鲜明特点。
全球IC基板生产以日本为主,产值占60%,包括第一大厂IBIDEN、SHINKO、NGK、Kyocera、Eastern等;台湾厂商位居第二、占30%,包括NanYa、Unimicron、Kinsus、ASE等;韩国则以SEMCO、Deaduck、LG为主要生产者。基板依其材质可分为BT(BismaleimideTriacine)和ABF(AjinnomotoBuild-up Film)两种。BT材质含玻纤,CTE小,不易热胀冷缩,材质硬、线路粗。主要用于手持设备、通信设备和存储;ABF材质线路较精密,导电性好、为Intel主导使用,广泛用于PC产品。生产BT基材(wire bond)主要为日商MitsubishiGasChemical(三菱瓦斯化学)、Hitachi Chemical(日立化成)各占全球市场50%、40%。 ABF基材,日本Ajinomoto(味之素)是唯一供应商。
基板结构:
叠层结构,由不同厚度的材料堆叠而成,有导电材料和非导电材料;过孔,用于连接不同层信号的孔。结构包含Via Hole(钻孔)、Via Land(孔环)、Hole Wall(孔壁)、Hole Cap(钻孔封帽)、Plugging Ink(塞孔油墨)等;表面处理(Surface Treatment),EG(电镀金)、Ni thickness(镍层厚度)、Au thickness(金层厚度)等……
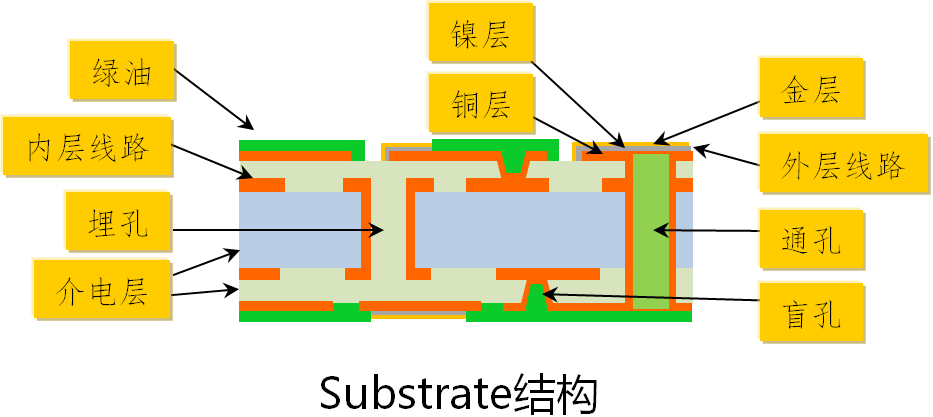
基板加工涉及的主要问题:
Layer structure capability(叠层结构能力),Trace/Pattern capability(图形/走线能力),Fingerpitch capability(金手指间距能力),CF/SM registration capability(阻焊加工能力)Drill capability(钻孔能力),Surface treatment(表面处理),Dimension tolerance capability(尺寸公差控制能力)……
基板线路制作工艺:
减成工艺(Subtractive Process):全面电镀(PanelPlating),图形电镀(PatternPlating),混合电镀(Panel-PatternPlating)。
加成工艺(Additive Process):全加成(Full Additive ),半加成(Semi-Additive),部分加成(Partial Additive)。
通过下面几种常见的载板制作流程,大家可以对载板工艺有个大概了解。由于载板加工工艺流程复杂,只对其主要步骤进行了罗列,不明之处可以到微信群——“IC封装设计”中去交流。对于加工步骤的详细解释说明,可以部分参考《IC封装基础与工程设计实例》第5章的内容。
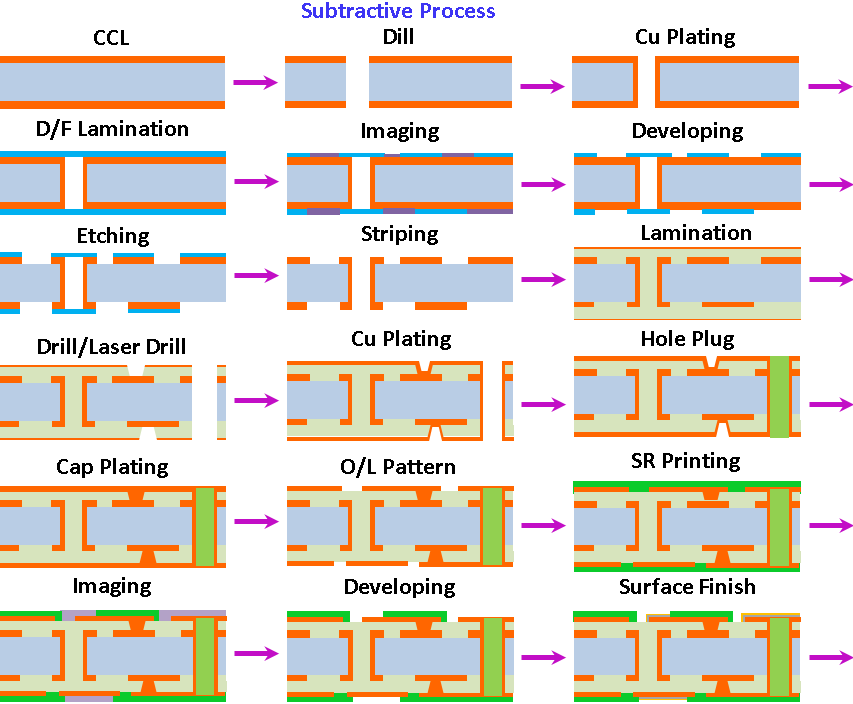
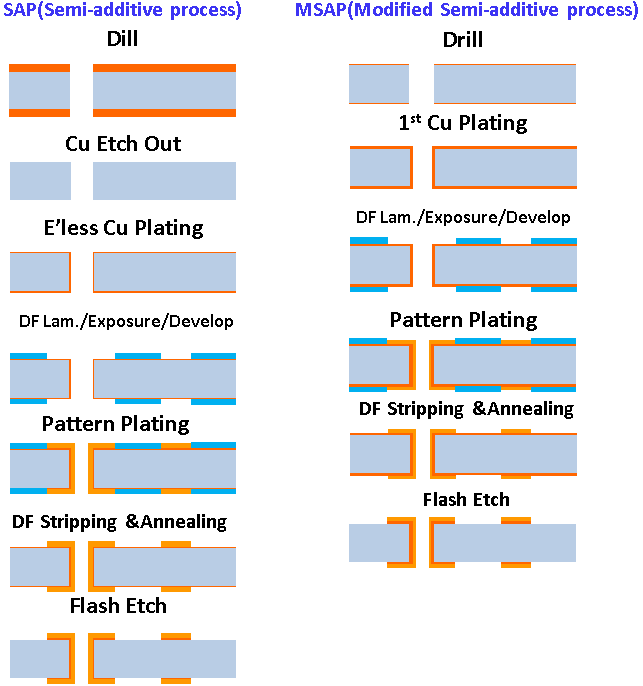
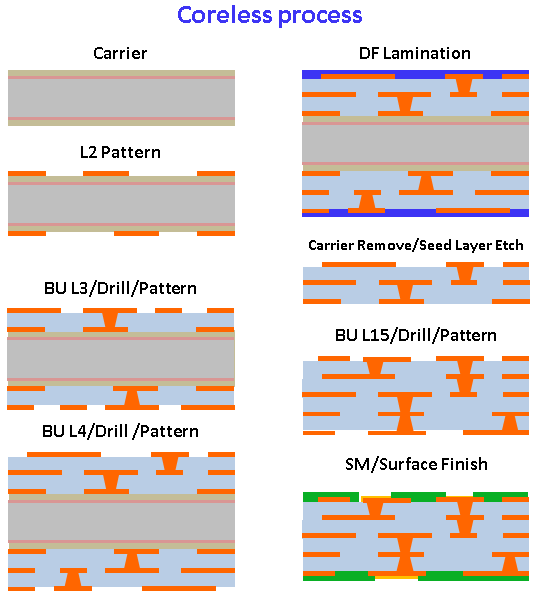
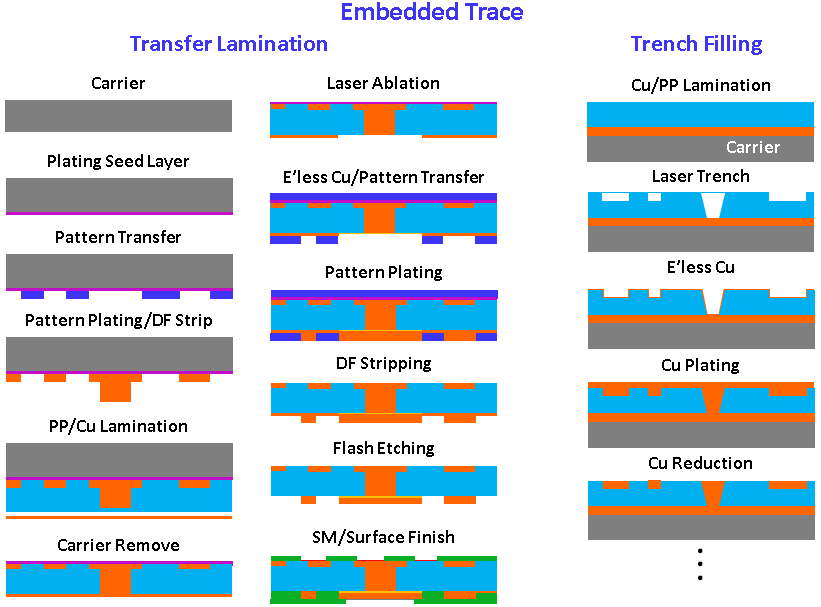
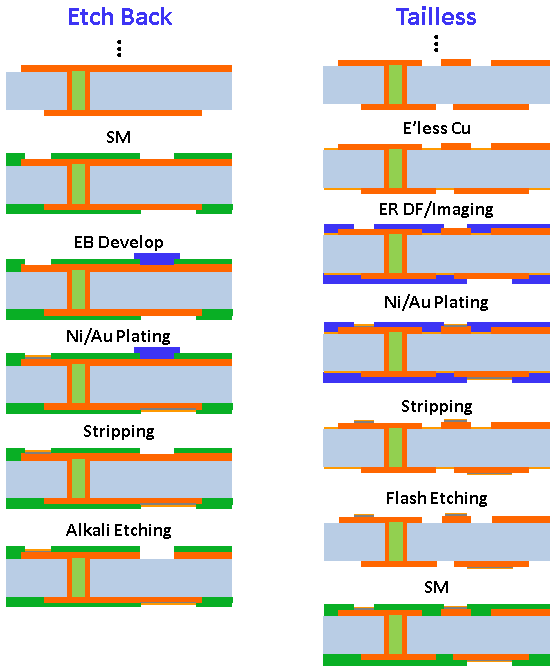
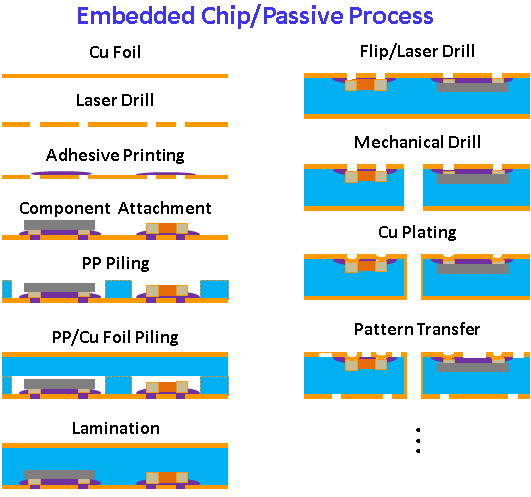
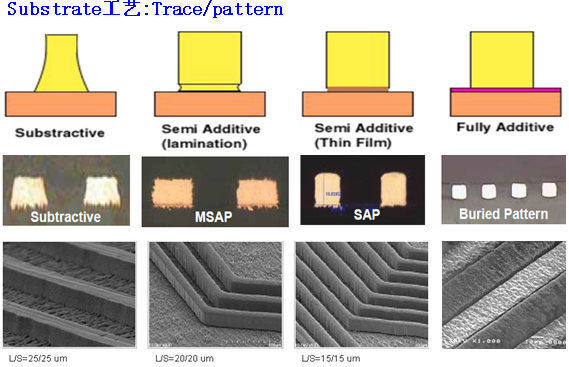
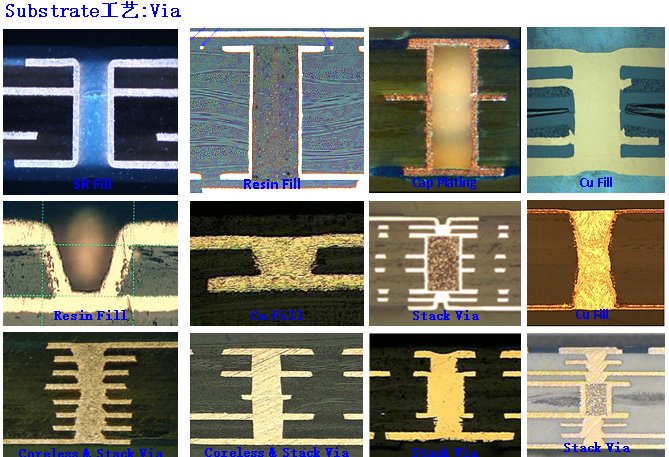
表面处理工艺(Surface Finish):

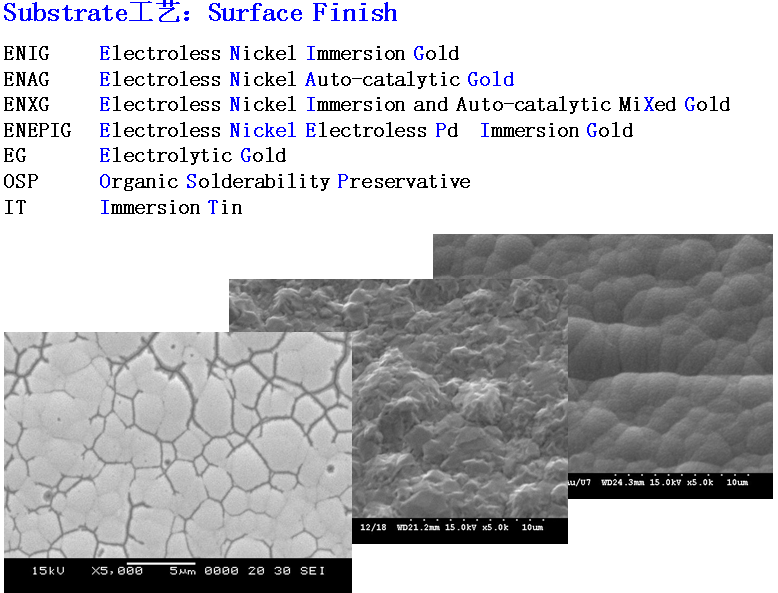
常用IC载板材料特性: