Ball Mounting(置球)
BGA封装是通过基板下表面的锡球(Solder Ball)与系统PCB实现互连的,本工序就是将锡球焊接在基板上的过程。工序可细分为如下图4步:
1. 用与BGA焊盘相应的治具沾取助焊剂(Flux),并将其点在BGA焊盘上;
2. 通过置球治具(Ball attach tool)真空吸取锡球,并转移至沾有助焊剂的焊盘上;松开真空开关,锡球在助焊剂的粘性作用下,粘贴在基板焊盘上;
3. 将上一步的基板通过热风回流焊,锡球在高温下熔化,并在助焊剂的帮助下,与基板焊盘浸润,冷却后,锡球与基板牢牢焊接在一起;
4. 焊接了锡球的基板,放入清洗机,把多余的助焊剂和脏污清洗掉,最后烘干。
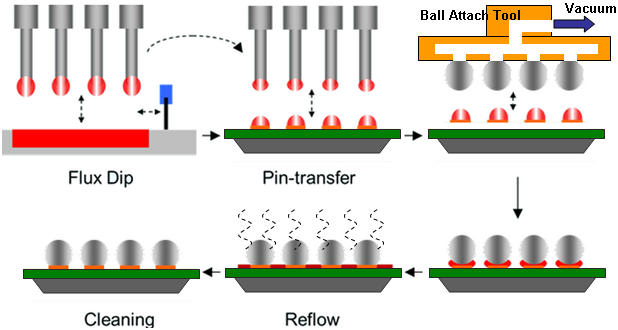
置球过程原理图
置球的原材料和设备:
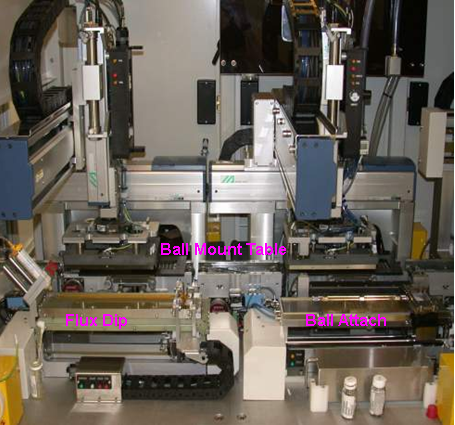
置球设备
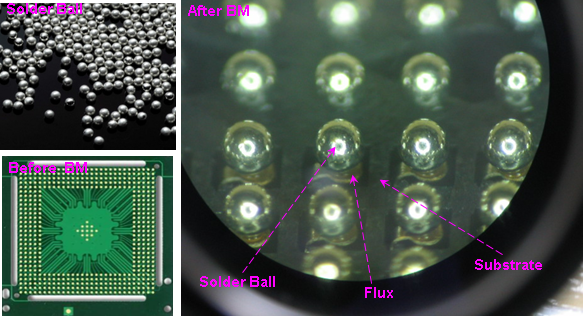
显微镜下置球效果
下面是全自动植球机 BPS-7200的置球视频以及回流焊视频,仅供参考。
点击视频链接: Ball Mount and Reflow.mp4
下一章节,我们会继续SiP的工艺流程,讲述Package Sawing(切单),敬请关注。








