电浆清洗(Plasma)
在Molding前会使用混合气体,对基板表面进行电浆清洗。主要是用O2 & H2混合气体,在金属面形成OH-基。Molding 工序前,采用此种清洗,可以增加与 Compound间的结合力,提高产品的可靠度,增加使用寿命。。
Molding(塑封)
本工序主要是把芯片和金线用塑胶密封起来,使其不受外界环境的影响而失效,主要过程如下:
1) 将完成超声焊接的基板,放置在注塑机的下模(Bottom chase)(见下图)上预热。
2) 将上模(Top chase)下压,并将预热后的环氧塑封料(Epoxy Molding Compound,简称EMC)从注塑口投入到投料罐(Pot)中。
3) 注塑杆(Plunger)加压后,熔化后的塑封料流入并充满模腔(Cavity),将芯片和焊接金线包封起来,同时模腔内的空气经空气口(Air vent)排出,
4) 待填充EMC硬化后,开模脱模,取出封好的成品。
EMC:是一种热固性树脂,主要成分为环氧树脂及各种添加剂(固化剂,改性剂,脱模剂,染色剂,阻燃剂等),为黑色块状,低温存储,使用前需先回温。其特性为:在高温下先处于熔融状态,然后其成分发生交联反应逐渐硬化,最终成型。

塑封模具上下模
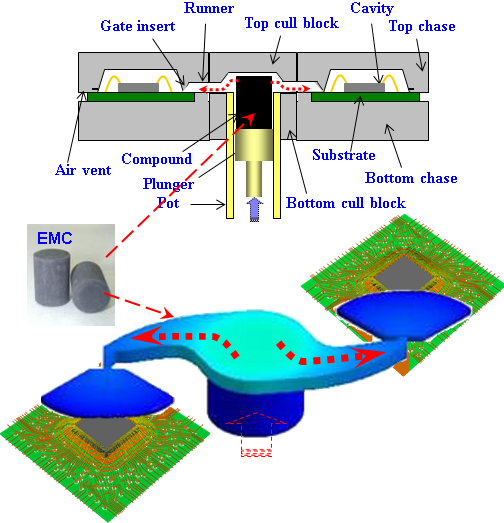
塑封模具结构及注塑过程示意图

实际注塑过程
下面视频是整个molding的工艺过程,前半部分是Moldex3D的模拟视频,后半部分是实际的注塑设备工作过程,仅供参考。
Post Mold Cure (塑封后烘烤)
把塑封后的产品放在烤箱内,加热到175+/-5oC ,保持2~8小时。主要作用是使EMC材料完全硬化,并消除塑封时产生的内应力。
EMC材料的环氧树脂等高分子成分,在高温下发生交联反应,生成网状的结构而硬化。在模封后交联反应还没有进行完全,模封后烘烤,可以使交联反应进行彻底,达到完全硬化。
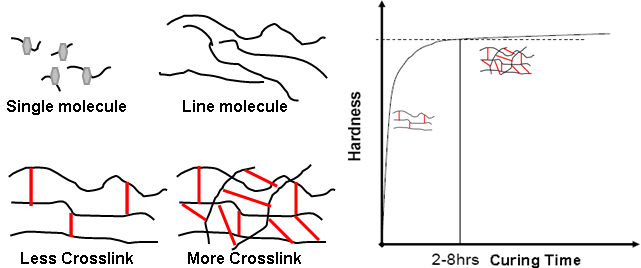
交连反应示意图及烘烤硬化关系
下一章节,我们会继续SiP的工艺流程,讲述Marking(印字),敬请关注。








